Podle serveru Engadget společnost Intel uvádí, že její nový skleněný substrát bude odolnější a efektivnější než stávající organické materiály. Sklo také umožní společnosti umístit více čipů a dalších komponent vedle sebe. To by pro společnost mohlo představovat problémy s ohýbáním a nestabilitou ve srovnání se stávajícími křemíkovými pouzdry využívajícími organické materiály.
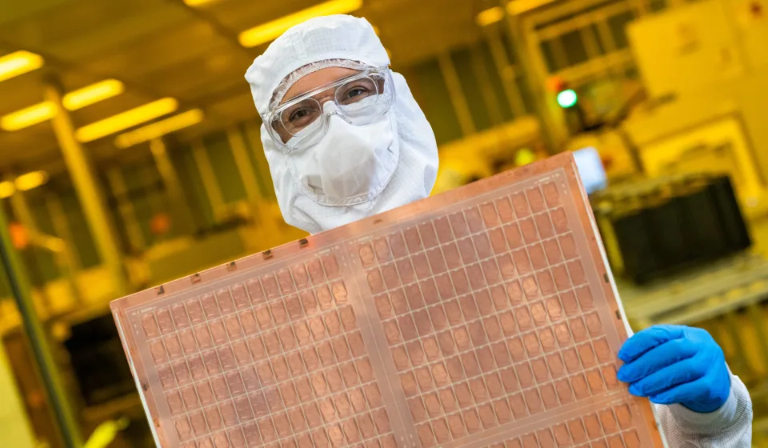
Intel se pyšní průlomem v technologii výroby substrátů.
Společnost Intel v tiskové zprávě uvedla, že: „Skleněné substráty odolávají vyšším teplotám, snižují zkreslení vzoru o méně než 50 % a mají extrémně nízkou rovinnost, což zlepšuje ohniskovou hloubku pro litografický tisk, a zároveň poskytují rozměrovou stabilitu potřebnou pro extrémně těsné spojení mezi vrstvami.“
Společnost tvrdí, že díky těmto možnostem skleněný substrát pomůže až desetkrát zvýšit hustotu připojení a umožní také vytváření „ultra velkých pouzder s vysokou produktivitou montáže“.
Společnost Intel údajně značně investuje do návrhu budoucích čipů. Před dvěma lety společnost oznámila svůj design tranzistoru „gate-all-around“, RibbonFET, a také PowerVia, která umožňuje směrovat napájení na zadní stranu polovodičového waferu čipu. Zároveň Intel oznámil, že bude vyrábět čipy pro službu AWS od společností Qualcomm a Amazon.
Intel dodal, že čipy využívající skleněné matrice uvidíme nejprve ve vysoce výkonných oblastech, jako je umělá inteligence (AI), grafika a datová centra. Tento průlom ve skle je dalším znamením, že Intel také rozšiřuje své pokročilé kapacity v oblasti balení ve svých amerických slévárnách.
Zdrojový odkaz















































































































Komentář (0)