Az Engadget szerint az Intel azt állítja, hogy az új üvegszubsztrátja tartósabb és hatékonyabb lesz, mint a meglévő szerves anyagok. Az üveg lehetővé teszi a vállalat számára, hogy több chipletet és más alkatrészt egymás mellé helyezzen. Ez kihívást jelenthet a vállalat számára a hajlítás és az instabilitás tekintetében a meglévő, szerves anyagokat használó szilícium tokozásokhoz képest.
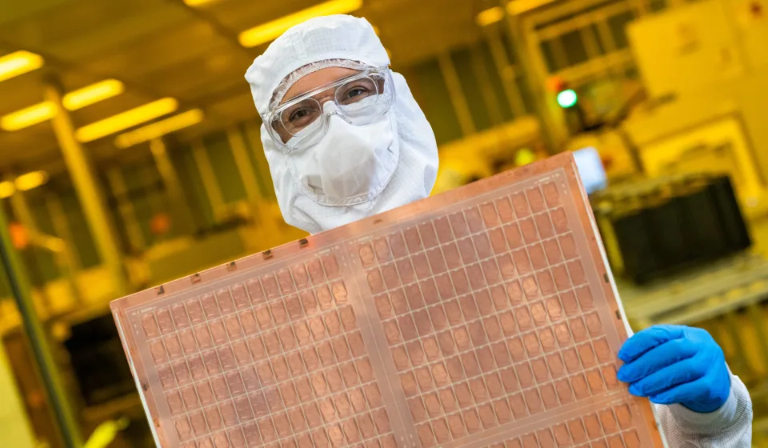
Az Intel áttörést ért el az aljzatgyártási technológiában.
Az Intel egy sajtóközleményben kijelentette, hogy: „Az üvegfelületek ellenállnak a magasabb hőmérsékletnek, kevesebb mint 50%-kal csökkentik a minta torzulását, és rendkívül alacsony síkfelülettel rendelkeznek, hogy javítsák a fókuszmélységet litográfiai nyomtatáshoz, miközben biztosítják a rendkívül szoros rétegközi kötéshez szükséges méretstabilitást.”
A vállalat azt állítja, hogy ezekkel a képességekkel az üvegfelület akár tízszeresére is növelheti a csatlakozási sűrűséget, valamint lehetővé teszi „ultra nagy, nagy összeszerelési termelékenységű csomagok” létrehozását.
Az Intel állítólag jelentős összegeket fektet be a jövő chipjeinek tervezésébe. Két évvel ezelőtt a vállalat bejelentette a „minden irányban kapuzó” tranzisztor-kialakítását, a RibbonFET-et, valamint a PowerVia-t, amely lehetővé teszi a tápellátás elvezetését a chip félvezető lapjának hátuljához. Ezzel egy időben az Intel azt is bejelentette, hogy chipeket fog gyártani a Qualcomm és az Amazon AWS szolgáltatása számára.
Az Intel hozzátette, hogy az üvegchipeket használó chipeket először nagy teljesítményű területeken, például a mesterséges intelligenciában (MI), a grafikában és az adatközpontokban láthatjuk majd. Ez az üvegáttörés egy újabb jele annak, hogy az Intel az amerikai öntödéiben is fokozza fejlett tokozási képességeit.
[hirdetés_2]
Forráslink












































































































Hozzászólás (0)