Engadgetによると、インテルは新しいガラス基板が既存の有機材料よりも耐久性と効率性に優れていると述べている。また、このガラス基板を用いることで、複数のチップレットやその他の部品を並べて配置することも可能になる。ただし、これは有機材料を用いた既存のシリコンパッケージと比較して、曲げや不安定性といった点で同社にとって課題となる可能性がある。
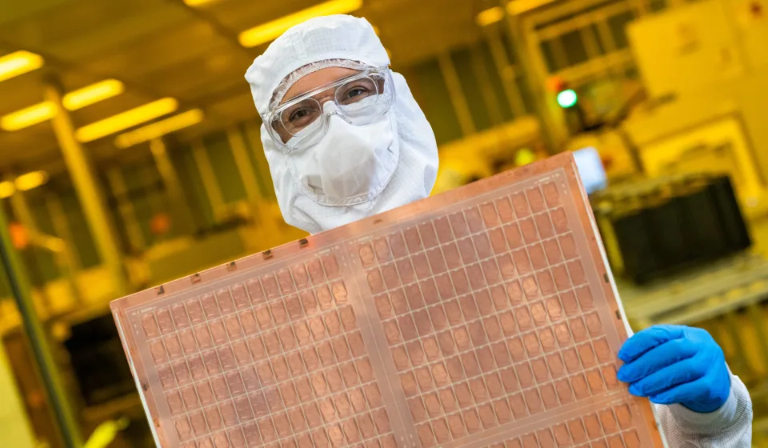
インテルは基板製造技術における画期的な進歩を誇っている。
インテルはプレスリリースで、「ガラス基板はより高い温度に耐え、パターン歪みを50%未満に抑え、極めて低い平面度によってリソグラフィ印刷の焦点深度を向上させるとともに、極めて強固な層間接合に必要な寸法安定性を提供する」と述べている。
同社は、これらの機能により、ガラス基板は接続密度を最大10倍に高めるとともに、「高い組み立て生産性を備えた超大型パッケージ」の製造を可能にすると主張している。
インテルは、将来のチップ設計に多額の投資を行っていると報じられている。2年前、同社は「ゲートオールアラウンド」トランジスタ設計であるRibbonFETと、チップの半導体ウェハの裏面に電力を供給できるPowerViaを発表した。同時に、インテルはクアルコムとアマゾンのAWSサービス向けチップの製造も発表した。
インテルは、ガラスダイを使用したチップはまず、AI(人工知能)、グラフィックス、データセンターといった高性能分野で登場するだろうと付け加えた。このガラス技術の飛躍的な進歩は、インテルが米国のファウンドリにおける高度なパッケージング能力を強化していることを示すもう一つの兆候である。
ソースリンク














































































































コメント (0)