Conform Engadget , Intel afirmă că noul său substrat de sticlă va fi mai durabil și mai eficient decât materialele organice existente. Sticla va permite, de asemenea, companiei să plaseze mai multe chipleturi și alte componente una lângă alta. Acest lucru ar putea prezenta provocări pentru companie în ceea ce privește îndoirea și instabilitatea în comparație cu cartușele de siliciu existente care utilizează materiale organice.
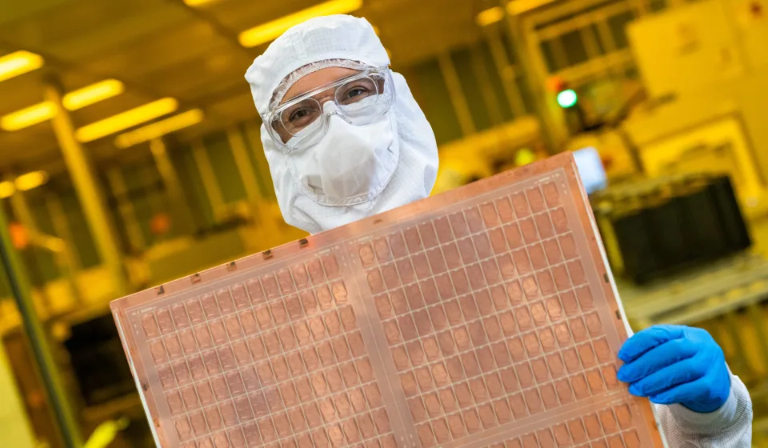
Intel se mândrește cu o descoperire inovatoare în tehnologia de fabricație a substraturilor.
Intel a declarat într-un comunicat de presă că: „Substraturile de sticlă pot rezista la temperaturi mai ridicate, pot reduce distorsiunea modelului cu mai puțin de 50% și au o planeitate extrem de scăzută pentru a îmbunătăți adâncimea focală pentru imprimarea litografică, oferind în același timp stabilitatea dimensională necesară pentru lipirea extrem de strânsă a straturilor intermediare.”
Cu aceste capacități, compania susține că substratul de sticlă va ajuta, de asemenea, la creșterea densității conexiunilor de până la 10 ori, precum și la crearea de „pachete ultra-mari cu productivitate ridicată de asamblare”.
Se pare că Intel investește masiv în proiectarea viitoarelor cipuri. Acum doi ani, compania a anunțat designul tranzistorului „gate-all-around”, RibbonFET, precum și PowerVia, care îi permite să direcționeze energia către spatele plachetei semiconductoare a cipului. În același timp, Intel a anunțat, de asemenea, că va construi cipuri pentru Qualcomm și serviciul AWS al Amazon.
Intel a adăugat că vom vedea pentru prima dată cipuri care utilizează matrițe de sticlă în domenii de înaltă performanță, cum ar fi inteligența artificială (IA), grafica și centrele de date. Această descoperire în domeniul sticlei este un alt semn că Intel își intensifică, de asemenea, capacitățile avansate de ambalare la turnătoriile sale din SUA.
Legătură sursă





![[Foto] Secretarul general și președintele To Lam prezidează o sesiune de lucru cu Comitetul Central pentru Politici și Strategii privind dezvoltarea industriei materialelor.](https://vphoto.vietnam.vn/thumb/1200x675/vietnam/resource/IMAGE/2026/05/21/1779359935432_a3-bnd-3129-1412-jpg.webp)

![[Foto] Președintele Adunării Naționale, Tran Thanh Man, în colaborare cu Comitetul permanent al Comisiei pentru Drept și Justiție](https://vphoto.vietnam.vn/thumb/1200x675/vietnam/resource/IMAGE/2026/05/21/1779378929214_ndo_br_1-4610-jpg.webp)





































































































Comentariu (0)