Engadget'e göre Intel, yeni cam alt tabakasının mevcut organik malzemelere göre daha dayanıklı ve verimli olacağını söylüyor. Cam ayrıca şirketin birden fazla çip ve diğer bileşenleri yan yana yerleştirmesine olanak tanıyacak. Bu durum, organik malzemeler kullanan mevcut silikon paketlerine kıyasla bükülme ve kararsızlık açısından şirket için zorluklar yaratabilir.
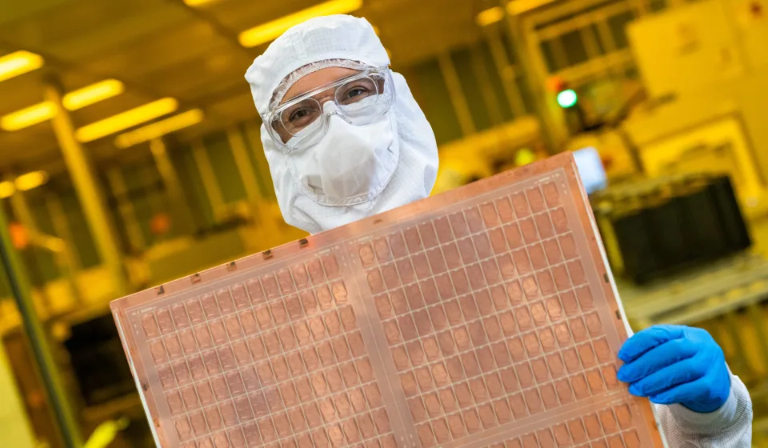
Intel, alt tabaka üretim teknolojisinde çığır açan bir gelişme kaydetti.
Intel bir basın açıklamasında şunları belirtti: "Cam alt tabakalar daha yüksek sıcaklıklara dayanabilir, desen bozulmasını %50'den daha az azaltabilir ve litografik baskı için odak derinliğini iyileştirmek amacıyla son derece düşük düzlüğe sahip olup, aynı zamanda son derece sıkı katmanlar arası bağlama için gereken boyutsal kararlılığı sağlar."
Şirket, bu özelliklerle cam alt tabakanın bağlantı yoğunluğunu 10 kata kadar artırmaya yardımcı olacağını ve ayrıca "yüksek montaj verimliliğine sahip ultra büyük paketlerin" oluşturulmasını sağlayacağını iddia ediyor.
Intel'in geleceğin çiplerinin tasarımına büyük yatırımlar yaptığı bildiriliyor. Şirket iki yıl önce, "her tarafı saran geçit" transistör tasarımı olan RibbonFET'i ve çipin yarı iletken levhasının arkasına güç yönlendirmesine olanak tanıyan PowerVia'yı duyurmuştu. Aynı zamanda Intel, Qualcomm ve Amazon'un AWS hizmeti için çipler üreteceğini de açıklamıştı.
Intel, cam kalıplı çiplerin ilk olarak yapay zeka (AI), grafik ve veri merkezleri gibi yüksek performanslı alanlarda kullanılacağını da sözlerine ekledi. Bu cam atılımı, Intel'in ABD'deki dökümhanelerinde gelişmiş paketleme yeteneklerini de artırdığının bir başka işareti.
[reklam_2]
Kaynak bağlantısı











































































































Yorum (0)