Згідно з Engadget , Intel стверджує, що її нова скляна підкладка буде міцнішою та ефективнішою, ніж існуючі органічні матеріали. Скло також дозволить компанії розміщувати кілька чіплетів та інших компонентів поруч. Це може створити проблеми для компанії щодо вигину та нестабільності порівняно з існуючими кремнієвими корпусами, що використовують органічні матеріали.
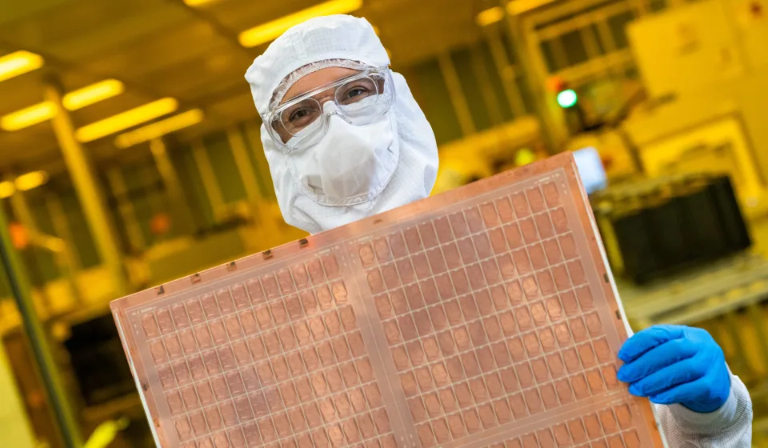
Intel може похвалитися проривом у технології виробництва підкладок.
У прес-релізі Intel заявила: «Скляні підкладки можуть витримувати вищі температури, зменшувати спотворення малюнка менш ніж на 50% та мати надзвичайно низьку площинність для покращення фокусної глибини для літографічного друку, забезпечуючи водночас розмірну стабільність, необхідну для надзвичайно щільного міжшарового з’єднання».
Завдяки цим можливостям, компанія стверджує, що скляна підкладка також допоможе збільшити щільність з'єднань до 10 разів, а також дозволить створювати «надвеликі корпуси з високою продуктивністю складання».
Повідомляється, що Intel значно інвестує в розробку майбутніх чіпів. Два роки тому компанія анонсувала свою конструкцію транзисторів RibbonFET з "gate-all-around", а також PowerVia, яка дозволяє їй направляти живлення на задню частину напівпровідникової пластини чіпа. Водночас Intel також оголосила, що створюватиме чіпи для сервісу Qualcomm та Amazon AWS.
Intel додала, що спочатку ми побачимо чіпи з використанням скляних кристалів у високопродуктивних областях, таких як штучний інтелект (ШІ), графіка та центри обробки даних. Цей прорив у сфері скла є ще однією ознакою того, що Intel також нарощує свої передові можливості з упаковки на своїх заводах у США.
Посилання на джерело















































































































Коментар (0)