Engadget 에 따르면 인텔은 새로운 유리 기판이 기존 유기 소재보다 내구성과 효율성이 뛰어나다고 밝혔습니다. 또한 이 유리를 사용하면 여러 개의 칩렛과 기타 부품을 나란히 배치할 수 있습니다. 이는 기존 유기 소재를 사용하는 실리콘 패키지에 비해 굽힘 및 불안정성 측면에서 인텔에 유리할 수 있습니다.
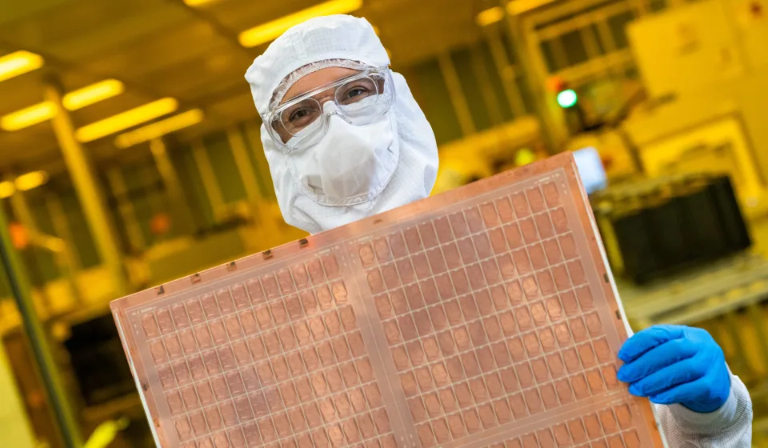
인텔은 기판 제조 기술에서 획기적인 발전을 이루었다고 자랑합니다.
인텔은 보도자료에서 "유리 기판은 고온을 견딜 수 있고, 패턴 왜곡을 50% 미만으로 줄이며, 리소그래피 인쇄 시 초점 심도를 향상시키기 위해 매우 낮은 평탄도를 가지는 동시에, 매우 견고한 층간 접합에 필요한 치수 안정성을 제공한다"고 밝혔습니다.
이러한 기능을 통해 유리 기판은 연결 밀도를 최대 10배까지 높일 뿐만 아니라 "높은 조립 생산성을 갖춘 초대형 패키지" 제작을 가능하게 할 것이라고 회사 측은 주장합니다.
인텔은 미래 칩 설계에 막대한 투자를 하고 있는 것으로 알려져 있습니다. 2년 전, 인텔은 트랜지스터를 전면에 배치하는 '게이트 올 어라운드(gate-all-around)' 설계인 리본FET(RibbonFET)과 칩 반도체 웨이퍼 뒷면으로 전력을 공급하는 파워비아(PowerVia) 기술을 발표했습니다. 동시에 인텔은 퀄컴과 아마존의 AWS 서비스용 칩도 생산할 계획이라고 밝혔습니다.
인텔은 인공지능(AI), 그래픽, 데이터 센터와 같은 고성능 분야에서 유리 다이를 사용한 칩이 먼저 출시될 것이라고 덧붙였습니다. 이러한 유리 기술 혁신은 인텔이 미국 파운드리에서 첨단 패키징 역량을 강화하고 있다는 또 다른 신호입니다.
[광고_2]
출처 링크











































































































댓글 (0)