Ifølge Engadget sier Intel at det nye glasssubstratet vil være mer holdbart og effektivt enn eksisterende organiske materialer. Glasset vil også tillate selskapet å plassere flere chiplets og andre komponenter side om side. Dette kan by på utfordringer for selskapet når det gjelder bøying og ustabilitet sammenlignet med eksisterende silisiumpakker som bruker organiske materialer.
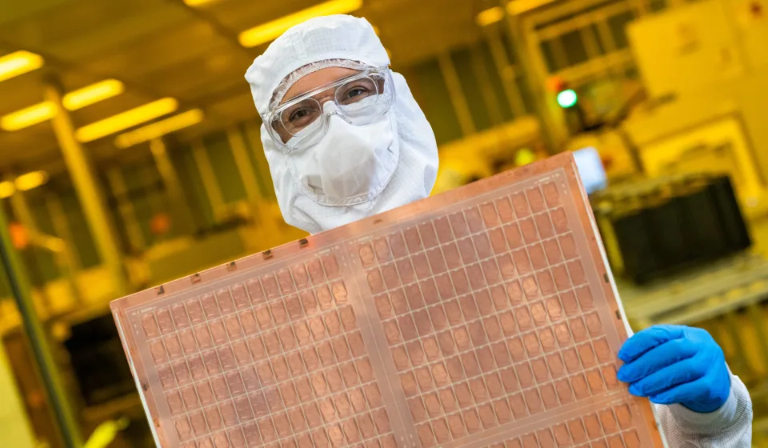
Intel kan skryte av et gjennombrudd innen substratproduksjonsteknologi.
Intel uttalte i en pressemelding at: «Glasssubstrater tåler høyere temperaturer, reduserer mønsterforvrengning med mindre enn 50 % og har ekstremt lav flathet for å forbedre brennvidden for litografisk utskrift, samtidig som de gir den dimensjonsstabiliteten som trengs for ekstremt tett mellomlagsbinding.»
Med disse egenskapene hevder selskapet at glasssubstratet også vil bidra til å øke tilkoblingstettheten med opptil 10 ganger, samt muliggjøre opprettelse av «ultrastore pakker med høy monteringsproduktivitet».
Intel investerer angivelig tungt i design av fremtidige brikker. For to år siden annonserte selskapet sitt «gate-all-around» transistordesign, RibbonFET, samt PowerVia, som lar dem rute strøm til baksiden av brikkens halvlederskive. Samtidig annonserte Intel også at de ville bygge brikker for Qualcomm og Amazons AWS-tjeneste.
Intel la til at vi først vil se brikker som bruker glassbrikker i høyytelsesområder, som kunstig intelligens (KI), grafikk og datasentre. Dette gjennombruddet innen glass er et annet tegn på at Intel også øker sine avanserte pakkemuligheter ved sine amerikanske støperier.
[annonse_2]
Kildekobling













































































































Kommentar (0)