Engadget के अनुसार, इंटेल का कहना है कि उसका नया ग्लास सबस्ट्रेट मौजूदा ऑर्गेनिक सामग्रियों की तुलना में अधिक टिकाऊ और कुशल होगा। ग्लास की मदद से कंपनी कई चिपलेट और अन्य कंपोनेंट को साथ-साथ लगा सकेगी। ऑर्गेनिक सामग्रियों से बने मौजूदा सिलिकॉन पैकेज की तुलना में, इससे कंपनी को झुकने और अस्थिरता से संबंधित चुनौतियों का सामना करना पड़ सकता है।
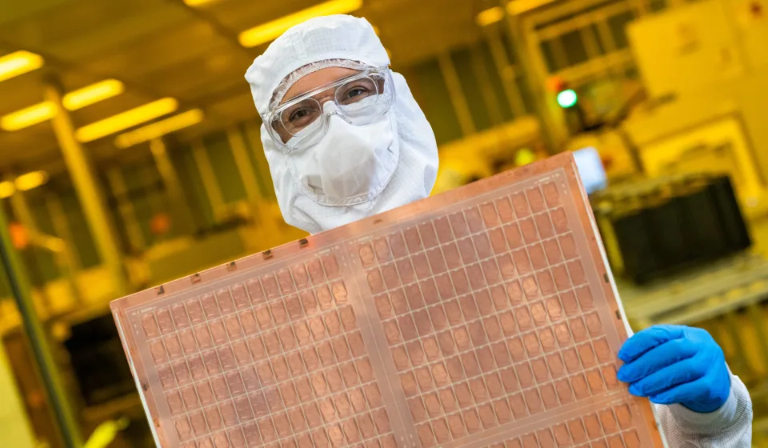
इंटेल ने सब्सट्रेट निर्माण प्रौद्योगिकी में एक अभूतपूर्व उपलब्धि हासिल करने का दावा किया है।
इंटेल ने एक प्रेस विज्ञप्ति में कहा कि: "ग्लास सब्सट्रेट उच्च तापमान को सहन कर सकते हैं, पैटर्न विरूपण को 50% से कम कर सकते हैं, और लिथोग्राफिक प्रिंटिंग के लिए फोकल डेप्थ को बेहतर बनाने के लिए बेहद कम समतलता रखते हैं, जबकि बेहद मजबूत इंटरलेयर बॉन्डिंग के लिए आवश्यक आयामी स्थिरता प्रदान करते हैं।"
इन क्षमताओं के साथ, कंपनी का दावा है कि ग्लास सब्सट्रेट कनेक्शन घनत्व को 10 गुना तक बढ़ाने में मदद करेगा, साथ ही "उच्च असेंबली उत्पादकता के साथ अल्ट्रा-लार्ज पैकेज" बनाने में भी सक्षम होगा।
खबरों के मुताबिक, इंटेल भविष्य के चिप्स के डिजाइन में भारी निवेश कर रहा है। दो साल पहले, कंपनी ने अपने "गेट-ऑल-अराउंड" ट्रांजिस्टर डिजाइन, रिबनफेट, और पावरविया की घोषणा की थी, जो चिप के सेमीकंडक्टर वेफर के पिछले हिस्से तक बिजली पहुंचाने की सुविधा देता है। उसी समय, इंटेल ने क्वालकॉम और अमेज़न की एडब्ल्यूएस सेवा के लिए चिप्स बनाने की भी घोषणा की थी।
इंटेल ने आगे कहा कि ग्लास डाई का उपयोग करने वाले चिप्स सबसे पहले उच्च-प्रदर्शन वाले क्षेत्रों में देखने को मिलेंगे, जैसे कि एआई (कृत्रिम बुद्धिमत्ता), ग्राफिक्स और डेटा सेंटर। ग्लास के क्षेत्र में यह महत्वपूर्ण प्रगति इस बात का एक और संकेत है कि इंटेल अपनी अमेरिकी फाउंड्री में उन्नत पैकेजिंग क्षमताओं को भी बढ़ा रहा है।
[विज्ञापन_2]
स्रोत लिंक


![[फोटो] राष्ट्रीय सभा के अध्यक्ष ट्रान थान मान आईपीयू-152 में भाग लेने के लिए तुर्की पहुंचे](https://vphoto.vietnam.vn/thumb/1200x675/vietnam/resource/IMAGE/2026/04/15/1776261003665_tnk10-jpg.webp)

![[फोटो] श्रीमती न्गो फुओंग ली, श्रीमती पेंग ली युआन से मिलती हैं और विचारों का आदान-प्रदान करती हैं।](https://vphoto.vietnam.vn/thumb/1200x675/vietnam/resource/IMAGE/2026/04/16/1776277858080_phu-nhan-1-jpg.webp)
![[फोटो] राष्ट्रीय सभा के अध्यक्ष ट्रान थान मान आईपीयू-152 के उद्घाटन सत्र में भाग लेते हुए।](https://vphoto.vietnam.vn/thumb/1200x675/vietnam/resource/IMAGE/2026/04/16/1776277863731_ctqh5-jpg.webp)
![[फोटो] महासचिव, राष्ट्रपति और उनकी पत्नी ने वियतनामी-चीनी मैत्री नेताओं से मुलाकात की।](https://vphoto.vietnam.vn/thumb/1200x675/vietnam/resource/IMAGE/2026/04/15/1776264829725_vna-potal-tong-bi-thu-chu-tich-nuoc-to-lam-gap-mat-nhan-sy-huu-nghi-viet-nam-trung-quoc-8703641-3130-jpg.webp)
![[फोटो] रात में मेरा बेटा: आकाशगंगा के बीच एक हजार साल पुराना धरोहर स्थल](https://vphoto.vietnam.vn/thumb/1200x675/vietnam/resource/IMAGE/2026/04/15/1776261039184_ndo_br_chon6-jpg.webp)



































































































टिप्पणी (0)